Let’s continue our look at the key presentations at IMAPS DPC 2022 from ASE, Amkor, Yole Développement and Adeia.
ASE
Lihong Cao discussed ASE’s “Enhanced Fanout Embedded Bridge Packaging Technology for Chiplet Integration”
The packaging industry is looking for alternatives to silicon through silicon via (TSV) technologies.
- Embedded SI die to replace large SI interposer
- Fanout RDL interposer with L/S > 1/1µm
- Better electrical performance (less insertion loss) by removal of SiTSV
Options are shown below. The latest ASE option is their FOCoS (fan-out chip-on-substrate) technology combined with an embedded SI bridge – dubbed FO-CoS-B.
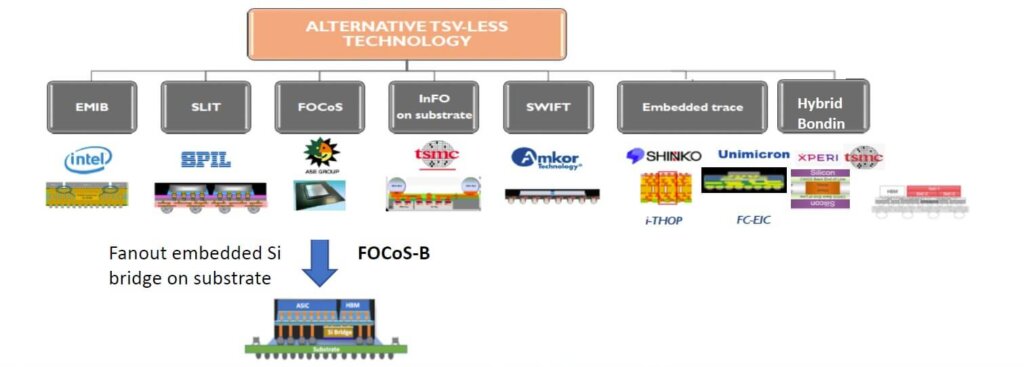
The FO-CoS-B process flow is shown below:
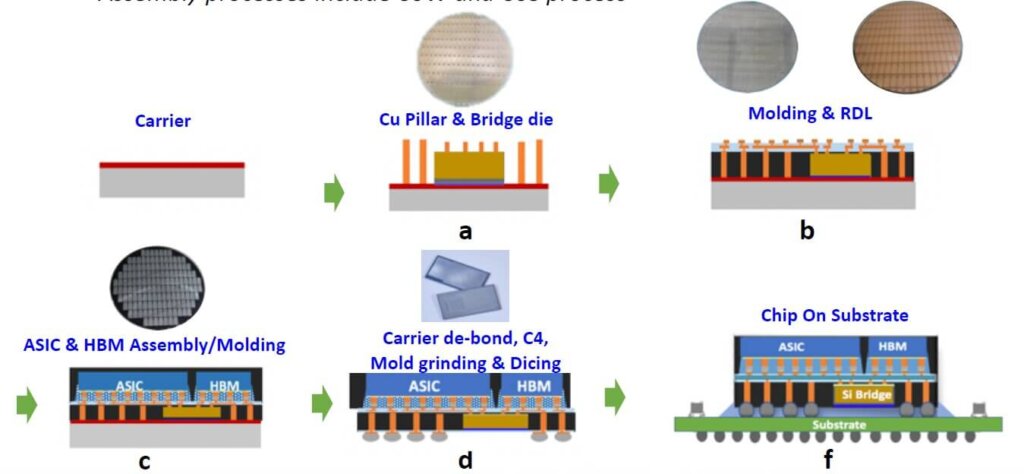
Package warpage is controlled by controlling the properties of the constituent materials (UF, EMC, RDL).
Yole Développement
Santosh Kumar of Yole Développement discussed Market and Technology Trends for the Fan out and 2.5D/3D Packaging Technology. He shared this ranking of packaging players by revenue.

Also of interest is Yole’s mapping of the high-end packaging supply chain.

As with many such listings, be careful because they can be misleading. They are really lists of who “can do” such technologies’ NOT where I can go to buy such technologies. Try going to GlobalFoundries or Intel and asking them to make silicon interposers for you…
Amkor
Curt Zwenger VP of system-in-package (SiP) product development discussed Empowering front-end cellular innovations with advanced SiP solutions. 5G enables the following market segments:

Cellular packaging follows the following packaging roadmap.
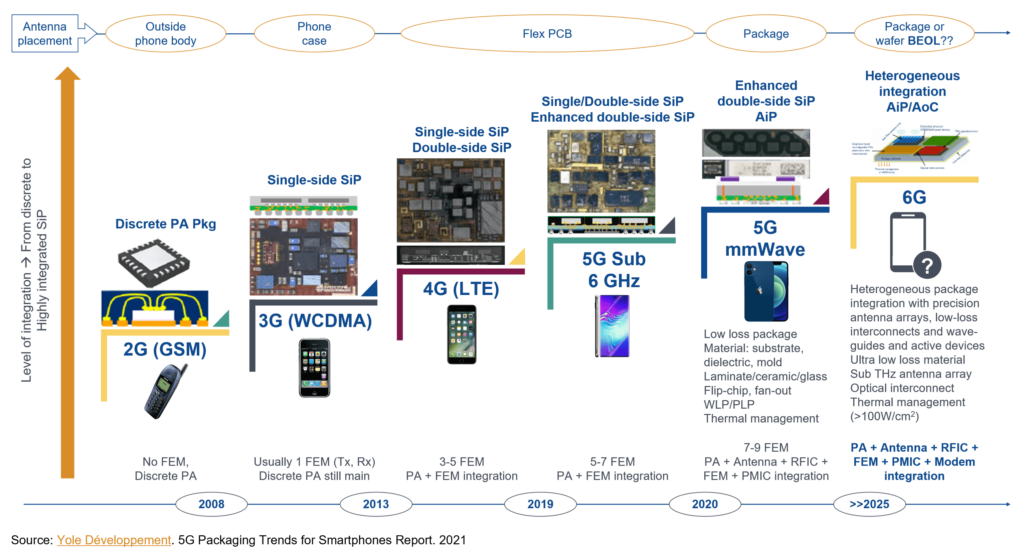
DSMBGA for 5G Front-end Functional Integration
- Increases module integration with significantly reduced package height
- Allows integration of antenna tuners and passive components
- Improved signal integrity and reduced losses
- Provides compartmental shielding for EMI isolation
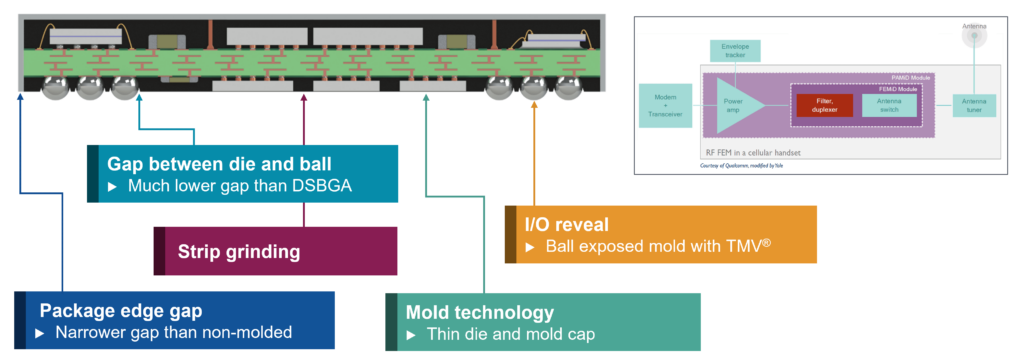 Adeia (Xperi)
Adeia (Xperi)
Laura Mirkarimi’s keynote presentation discussed Hybrid Bonding for the Next Generation of High-performance Devices. Xperi has been working on the adoption of hybrid bonding since its acquisition of Ziptronix in 2015. The holding company recently re-branded its IP division as Adeia, and the DBI and DBI Ultra now fall under that.
Hybrid bonding forms direct copper-copper bonds at fine pitch (<1 – 20µm) and is expected to be the widely adopted replacement for micro bumps and copper pillar bumps.
IFTLE has discussed this technology previously.
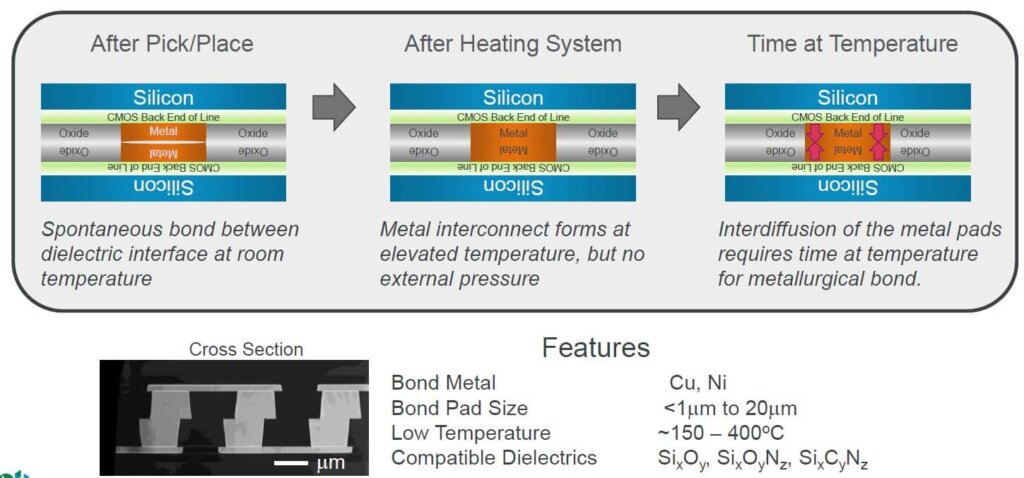
Adeia’s hybrid bonding process flow is shown below:

Its manufacturing timeline is shown below:
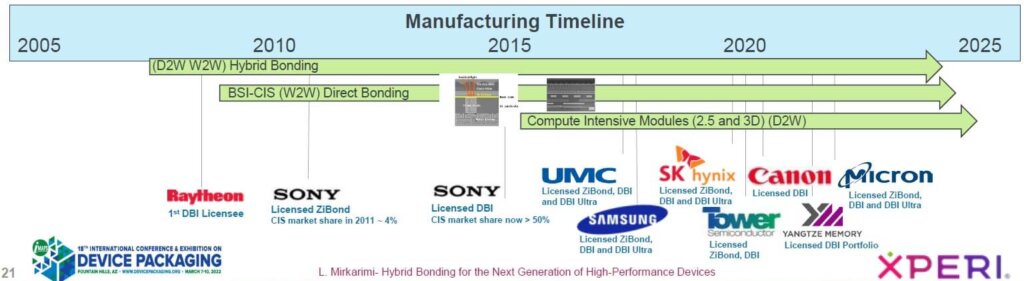
Adeia is working with the following equipment suppliers: Besi, K&S, ASM, and SUSS Microtec.
Hybrid bonding activity is going on at the following sites:
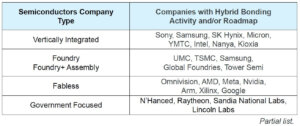
To stay up on all the latest on advanced packaging stay linked to IFTLE…………………………..
















